【华中科大演讲】- 先进封装用陶瓷基板技术研发与产业化
2024第五届中国电子通讯设备结构设计及热管理技术论坛”将于2024年3月18-19日在上海举办。

2024第五届中国电子通讯设备结构设计及热管理技术论坛”将于2024年3月18-19日在上海举办。

此次大会共安排了22场主题演讲,主要围绕电子通讯行业发展趋势及热管理挑战、通讯基站与卫星热管理技术、智能终端热管理与AI芯片封装技术等进行探讨。武汉利之达科技股份有限公司创始人兼首席技术专家陈明祥教授受邀参会并发表重要主题演讲报告。

武汉利之达科技股份有限公司(以下简称“利之达科技”)宣布完成近亿元B轮融资,本轮融资由洪泰基金领投,信禾资本和长江日报基金跟投。

2024半导体先进技术创新发展和机遇大会将于2024年5月22-23日在苏州·狮山国际会议中心组织举办。武汉利之达科技股份有限公司创始人/技术专家陈明祥教授将在本次会议上做专题报告,与您探讨先进封装用陶瓷转接板技术研发与产业化。
湖北利之达三维陶瓷电路板生产项目预计2024年5月整厂投入生产。投产后预计年产200万片电镀陶瓷基板,年产值预计2亿元。

2024第十三届中国(北京)国防信息化装备与技术博览会,将于6月5-7日在北京·中国国际展览中心朝阳馆举办

2024年11月8日,特朗普再度当选不到3天,媒体报道台积电(TSMC)已向所有中国大陆AI芯片客户发送正式电子邮件,宣布自11月11日起,将暂停向中国大陆AI/GPU客户供应所有7nm及更先进工艺的芯片。

为使社会各界更加全面知悉科技创新税费优惠政策、更加便捷查询了解政策,更加准确适用享受政策,财政部、科技部、海关总署、税务总局联合编写了《我国支持科技创新主要税费优惠政策指引》

县城也有金凤凰。目前,利之达出货的TCV陶瓷基板,主要应用在半导体照明、激光与通信等领域。眼下,第三代半导体、新能源汽车、人工智能等新兴产业迅速崛起,对高性能陶瓷基板需求也越来越大。

2024年12月21-22日,武汉利之达科技股份有限公司2024年终总结暨2025年发展规划会议在湖北应城市汤池镇成功举行,公司领导、各部门经理及工艺主管20余人参加了本次会议。
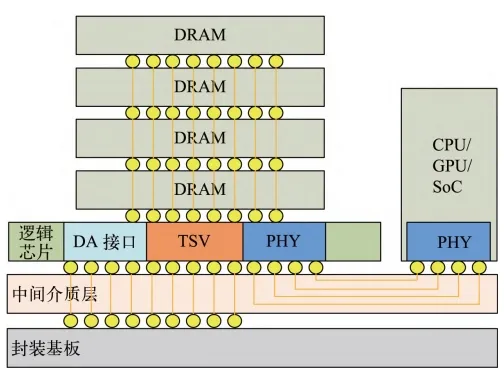
随着生成式人工智能和大模型技术的快速发展,AI处理器需求呈“井喷”式增长,具有高带宽、大容量、低延迟等特点的HBM成为AI行业的主流存储方案,但目前这一产品的产能仍存在很大缺口。

随着电子器件的功率和集成度越来越高,电子封装对散热材料的要求也在不断提升,研制新型电子封装材料成为提升电子器件功率水平的一大关键点。金刚石/铜复合材料(DCC)因具有热导率高、热膨胀系数可调等优势成为当前的研究热点。
